KYOTO, Japan--(BUSINESS WIRE)--Apr 27, 2026--
日本京瓷公司(Kyocera Corporation,社長:坂口志郎)今日宣布,將推出一款新型多層陶瓷核心基板,專為先進半導體封裝而設,以應對人工智能(AI)數據中心架構演變下,xPU(通用處理器)(1) 及交換機ASIC(專用積體電路)等晶片複雜性日益增加的需求。這款新產品將於2026年5月26日至29日,在美國佛羅里達州奧蘭多(Orlando, Florida, USA)舉行的國際半導體封裝技術會議ECTC 2026上首次亮相。
該新型核心基板採用京瓷專有的精密陶瓷(Fine Ceramic)材料製造,專為高密度佈線及卓越剛性而設計。京瓷公司指出,這些特性可顯著減少高性能半導體封裝中的變形(翹曲)問題,這正是隨著設備集成度及處理速度需求不斷提升所面臨的一大挑戰。
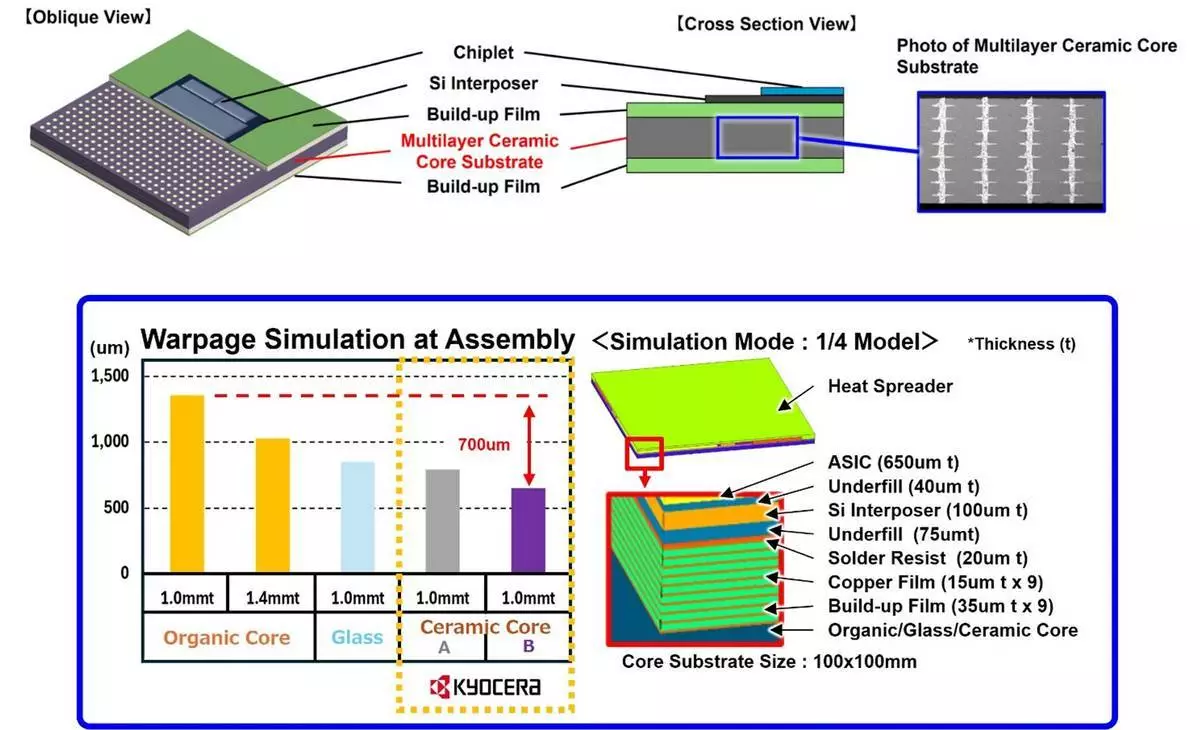
2.5D整合翹曲比較及模擬模型 AP圖片
(1):xPU是處理人工智能(AI)的各種處理單元(PU)的統稱,例如中央處理器(CPU)及圖形處理器(GPU)。
生成式人工智能(AI)及大型語言模型(large language models)的發展,正推動全球人工智能數據中心的普及,並對高性能xPU及ASIC半導體產生龐大需求,這些晶片需要更大、更密集的封裝基板,尤其是在2.5D封裝(2)方面。傳統由有機材料製成的核心基板,由於翹曲及佈線微型化等挑戰,特別是在較大尺寸下,已成為提升性能的瓶頸。京瓷公司正利用其在層壓陶瓷材料方面的專業知識,透過新型多層陶瓷核心基板解決這些限制,為先進半導體封裝提供更高的剛性及更精細的佈線。
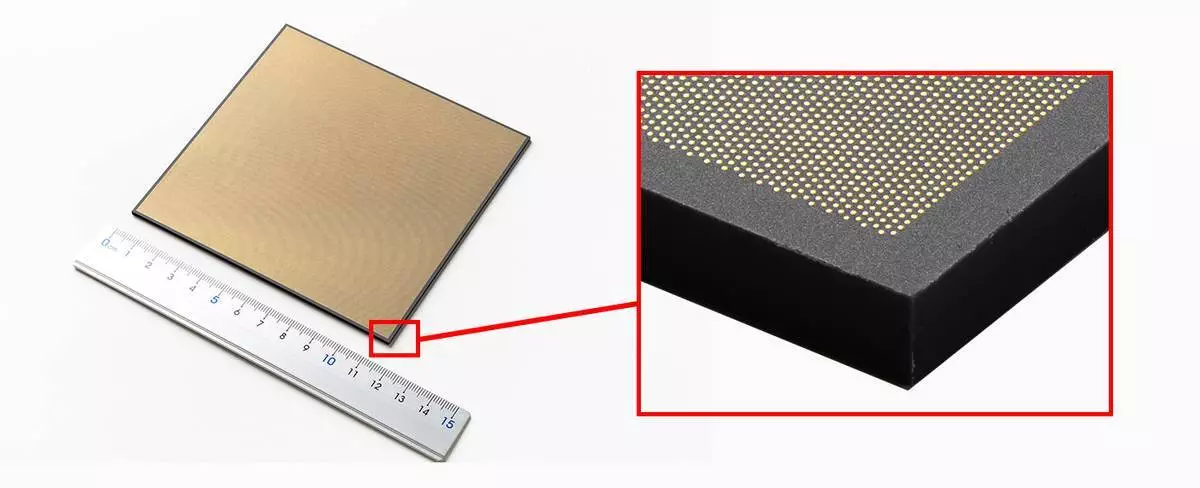
先進半導體封裝用多層陶瓷核心基板 AP圖片
(2):2.5D封裝(2.5D packaging)是指一種結構,其中多個積體電路晶片(IC chips)並排置於高密度中介層(interposer,即中繼基板)上,利用精細電路圖案及垂直層間佈線以提升處理速度。
主要特點
1. 高剛性多層陶瓷核心基板,有效減少大型封裝基板的翹曲問題
京瓷的多層陶瓷核心基板,相比有機材料製成的核心基板,提供更高的剛性及抗變形(彎曲)能力,從而最大限度地減少每個安裝階段的翹曲。因此,京瓷的多層陶瓷技術能夠利用更纖薄的基板(3)實現更高的設備性能,同時促進進一步的微型化。
(3):根據京瓷公司於2026年2月的模擬結果。
2. 多層陶瓷結構實現更精細佈線
在多層陶瓷基板中,陶瓷層之間的導電路徑稱為「通孔」(vias)。這些通孔在陶瓷可塑狀態下(燒結前)形成,相比傳統有機核心基板用於製造通孔的鑽孔工藝,透過卓越的微加工技術實現更精細的佈線。陶瓷基板所實現的更小通孔直徑及更緊密通孔間距,有效解決了傳統有機核心基板在高密度佈線方面所面臨的挑戰。
3. 支持定制設計要求及設計階段的性能模擬
在設計階段,京瓷公司會根據設備性能目標及指定的安裝工藝,提供熱學、電學及基板翹曲的模擬服務。這些模擬數據可確保客戶的開發效率更高,並有助於成品設備實現其設計目標。
京瓷公司將繼續致力於開發新的封裝材料及技術,以滿足半導體行業不斷變化的客戶需求。
關於京瓷
京瓷公司(Kyocera Corporation,東京證券交易所代碼:6971)作為京瓷集團(Kyocera Group)的母公司及全球總部,於1959年成立,初期主要生產精密陶瓷(Fine Ceramics,亦稱「先進陶瓷」)。透過將這些工程材料與金屬結合,並整合其他技術,京瓷已發展成為廣泛行業的領先陶瓷部件供應商,產品涵蓋汽車部件、半導體封裝、電子設備、智能能源系統、打印機、影印機及流動電話等。截至2025年3月31日止年度,該公司的綜合銷售收入總計達2萬億日圓(約132億美元)。京瓷公司入選《福布斯》(Forbes)雜誌2025年「全球2000強」(Global 2000)全球最大上市公司榜單,並獲《華爾街日報》(The Wall Street Journal)評為「全球100家最可持續管理公司」之一。2026年1月,京瓷公司連續第五年入選科睿唯安(Clarivate)的「全球創新百強」(Top 100 Global Innovators)榜單。
(美聯社)